无铅低温焊锡膏提高可靠性的三种技术路线-低温高强度低温锡膏原理
摘要
随着电子元器件的轻薄小化的趋势,原有的电子与半导体封装用无铅软钎焊料如SAC305、SAC0307等无铅锡膏产品已经无法满足现代电子产品封装对无铅锡膏的要求,传统的无铅低温锡铋系焊锡膏Sn42Bi58又存在在焊接界面铋富集的现象(如图1,注:矿物晶体受力后常沿一定方向破裂并产生光滑平面的性质称为解理(Cleavage)),导致锡膏焊接强度低,因此传统无铅低温Sn42Bi58焊锡膏可靠性很难满足高端电子产品使用的各种复杂环境下的要求。深圳市福英达公司无铅低温高可靠性FT\FSA\FL 系列锡膏、锡胶、锡粉产品,采用的全新复合增强技术路线,有效提高可靠性,焊点推力强度接近SAC305焊锡膏.
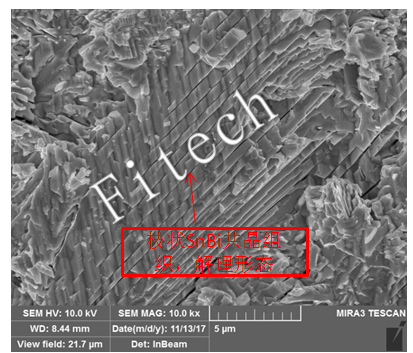
2016年全球焊料界在某国际知名芯片企业的号召下,多家企业和研究机构投入大量人力物力开展了对无铅低温高可靠性焊料的研发,人们都在寻找一种既可以像传统的有铅Sn63Pb37焊锡膏一样,在较低的工艺温度下(210℃)完成焊锡膏的回流焊接过程,又可以得到如Sn63Pb37和SAC305焊锡膏一样或者相近的符合高可靠性要求的无铅焊接材料合金,无铅焊锡膏中合金的金属相图的特性决定了现有焊锡膏合金的种类,使得可以为无铅焊料界选择的合金十分有限,经过全球各国科学家和工程师近6年的努力,终于在原来认为不可能的无铅锡膏合金种类基础上,开辟了几条可行的无铅低温焊锡膏提高可靠性的技术路线,基本实现了无铅低温高可靠性的焊接目的。
金属相图决定了无铅低温高可靠性锡膏焊料,现阶段最佳路线仍然是以原有的无铅低温锡铋合金为基础,选择不同的锡膏技术改进方法,改善无铅低温锡铋合金焊点IMC附近的富铋现象,减少无铅低温锡膏焊点的脆性和IMC在复杂环境下的增厚现象。目前主要有以下三种技术路线:
第一种是在原有的低温无铅Sn42Bi58合金中添加其他增强微量元素,如镍(Ni)、锑(Sb)、钴(Co)、铜(Cu)、银(Ag)、铈Ce等。使其在锡膏回流焊接过程中在IMC附近形成固溶粒子,改变锡膏中锡铋共晶合金的金相结构,实现金相结构的固溶强化和微量元素粒子的弥散强化,在复杂环境的可靠性实验中,无铅低温锡膏形成的焊点IMC附近的富铋现象得到了改善,金相结构也得到增强。
第二种是采用复合焊料技术。在原有低温无铅Sn42Bi58锡膏的助焊剂中增加了有机合成树脂,有机合成树脂在Sn42Bi58合金熔融固化的同时产生有机基团的交联反应。形成合成树脂在外、合金焊点在内的复合焊点。由于锡膏中合成树脂对Sn42Bi58合金焊点的保护,使焊点达到高绝缘电阻值和高焊接强度,但不足之处是焊料成本增加和工艺性能受到限制。
第三种技术路线就是深圳市福英达公司采用的全新的复合焊料方法。在原有的低温无铅Sn42Bi58锡膏合金粉末中,增加了含有锡Sn、银Ag、铟In、 铜Cu、锑Sb、钴Co、铈Ce等多种元素的微米和纳米级粉末。这些多种尺寸的粉末混合后与助焊剂搅拌成锡膏,这种混合型锡膏在<210℃以下的回流过程中,形成了特殊的“平头哥”回流曲线,(如图2),使原有的Sn42Bi58共晶低温合金在回流过程中的回流峰值温度下,完成一个微冶金过程,形成了新的焊点合金结构,这种焊点合金是一个亚共晶的锡铋合金体系,他具有几个特点:

①.无铅低温锡膏Sn42Bi58共晶合金在融化过程中容易形成富铋层(脆性结构),这是由于Sn在液相Bi中固溶量较低(21%),容易析出并与焊盘铜界面形成SnCu化合物。对此,福英达率先在锡膏配方中加入单质微米/纳米Sn。由于单质纳米Sn的加入,使得铜焊盘优先与锡膏中的纳单质纳米Sn反应形成新的IMC结构,阻止了焊点IMC附近的Sn42Bi58共晶合金中锡元素的析出,保证了锡膏中Sn42Bi58共晶合金的组分平衡,这种由焊锡膏中单质微米和纳米Sn抢先与铜焊盘反应形成新IMC的方法我们称之为“占位”法。 “占位”法阻止了锡膏合金中锡元素析出,保证了锡膏主体Sn42Bi58共晶合金的金相稳定性;并阻止了焊锡膏中铋元素偏析形成的枝状共晶体,而这种枝状共晶体被认为是形成脆性焊点的主要原因。
②.由于焊锡膏中锑(Sb)、银(Ag)、铜(Cu)、铟(In)、钴(Co)、铈Ce等纳米金属粒子在回流微冶金过程中的弥散和冷却后的固溶强化功能,阻隔了焊点中锡铋共晶合金内晶粒的长大和偏析。在后续的复杂环境可靠性实验中,这种锡膏形成的焊点结构中IMC生长速度缓慢,并且不会在其附近生成连接成带状的富铋层,保证了锡膏焊点的高可靠性。
③.迄今为止,由国际电子生产联盟iNEM组织的低温焊料系统可靠性试验结果表明,复合型无铅低温锡膏、锡胶具有高抗冲击性能,试验数据显示其抗冲击性能已接近传统的SAC305锡膏。深圳市福英达工业技术有限公司研发部的试验数据也证实了上述①②中的理论推论。我司高温高湿可靠性试验的数据表明,我司的复合型无铅低温锡膏、锡胶焊点的推力可达到传统SAC305锡膏焊点推力的85%。并且其IMC厚度薄于SAC305锡膏焊点。
总结:
复合型无铅低温锡膏、锡胶的诞生,是全球焊料界科学家和工程师共同努力的成果,实现了<210℃回流峰值温度下,高强度高可靠性焊接的目标。深圳市福英达工业技术有限公司关于该技术的发明专利《微米/纳米颗粒增强型复合焊料及其制备方法201711280945.3 》已经由中国专利局在2020年10 月23日授权,同时该专利申请了PCT进入美国日本实审阶段。我司的复合型高可靠性无铅低温锡膏,已经率先在全球微电子与半导体行业推广应用,并成为全球电子封装行业高可靠性无铅低温锡膏的技术主流方法和主要产品。
-End-









 返回列表
返回列表



